|
“夹杂键合”——这四个字,似乎正在成为半导体巨头们心照不宣的下一张王牌。 晶圆代工、存储芯片、征战龙头,三家看似赛说念不同,门路图上却同期标出了吞并个地方。台积电、三星、SK海力士、ASML…谁王人不敢掉队。 那么问题来了,为什么悉数顶尖玩家,王人在偷偷布局这项期间?谜底很简便——当摩尔定律方法踉跄,先进封装的冲突口,恰公正在“夹杂键合”这一环。 01 夹杂键合的牌局,仍是发牌了 早在2024年夹杂键合期间的热度便居高不下,而近期其热度再度升温,则收获于 SK 海力士的最新贪图:不才一代 HBM4 中崇拜接受这项期间。 在4月28日于首尔举行的一场半导体会议上,SK海力士期间负责东说念主金钟勋(Kim Jong-hoon)显现,公司应用于HBM的夹杂键合期间良率较两年前已显贵升迁,12层堆叠居品的考证责任仍是完成,现在正发奋于升迁大范畴分娩的产量。 业内东说念主士瞻望,夹杂键合期间将从HBM4运行引入。跟着16层HBM居品参加生意化阶段,这项期间可能会从本年下半年或来岁运行逐渐部署。在此前的居品贪图中,夹杂键配合为HBM5的必需期间。 字据机构Yole的统计及预测,2020年公共夹杂键合征战商场范畴达到3.2亿好意思元,瞻望2027年D2W/W2W商场范畴将分散攀升至2.3亿/5.1亿好意思元,年复合增长率(CAGR)达69%/16%,远超半导体行业举座增速,突显该鸿沟强盛增长后劲。 那么为什么夹杂键合期间如斯迫切? 夹杂键合,或称为Hybrid Bonding,是一种先进的半导体封装期间,可好意思满芯片间铜-铜和氧化物-氧化物的平直流畅,无需微凸块(Micro-bump)的辅助结构,从而好意思满电路的互联。这种方法显贵提高了互连密度、电气性能和优异的热服从,使其成为下一代半导体器件制造的要害期间。 夹杂键合工艺从晶圆的名义处理运行,晶圆经过化学机械平坦化(CMP)以获取超平坦的名义。此枢纽确保铜和氧化硅层王人得到充分的走漏以进行键合。名义准备好后,晶圆被精准大地对面瞄准。键合不错在室温下进行,但频繁会进行退火枢纽以加强金属间的流畅,从而形成坚固且高度可靠的互连。 现在该期间主要分为D2W/W2W两种类型, 分散对于小尺寸/大尺寸芯片具有资本的上风;晶圆对晶圆(wafer-to-wafer)键合除名雷同的经过,但省去了其中一个晶圆的切割和清洁枢纽,遏抑了浑浊风险并提高了服从,晶圆对晶圆键合大范畴应用在图像传感器CIS和3D NAND存储器的制造工艺中。而在芯片对晶圆(die-to-wafer)夹杂键合中,单个芯片被切割并清洁以去除浑浊物,然后被翻转并瞄准到成见晶圆上。通过等离子体活化期间窜改名义性情来增强粘附力,确保键合牢固且无颓势。这种工艺比晶圆间键合愈加清贫,但这种工艺变化对于逻辑和HBM很特等想。 现在,传统的互联期间包括引线键合、倒装芯片键合和硅通孔(TSV)键合等,然则就当下来看,这些期间各自濒临着不同的局限。 传统引线键合期间通过金属引线好意思满芯片与基板的电气流畅,这种方法诚然资本便宜且工艺训练,但受限于引线长度和布局神态,信号传输旅途较长,难以稳定高性能筹画芯片的需求。 倒装芯片键合期间通过在悉数这个词芯片正面叮嘱锡球/铜柱凸块,流畅密度升迁的同期还裁减了信号传输旅途,被庸俗应用于CPU、GPU和高速DRAM芯片的封装。不外,当凸点间距减弱到40μm以下时,传统回流焊工艺会出现翘曲和精度问题。 硅通孔期间是通过在硅片内制作垂直知道孔,填充金属(如铜或钨)好意思满电气互联的工艺。与传统的水平布线神态比较,TSV期间大幅裁减了芯片间的信号传输旅途,为系统微型化、高性能和低功耗提供了可能性。不外硅通孔期间的制形资本较高,工艺复杂性也要越过不少。
针对传统TSV+微凸点等工艺的诸多痛点,夹杂键合期间的应用提供了有用的处置地方,从性能到结构对HBM工艺进行了全面优化与升迁。其中在性能升迁上,最隆起的少量等于互连密度的飞跃——它将互连间距压缩至10μm以下,较传统工艺密度升迁15倍。结构优化上,现阶段接受TSV与Cu-Cu互筹划合的夹杂架构,兼顾兼容性与性能;将来将好意思满全夹杂键合,澈底取消TSV,通过100% Cu-Cu互连好意思满16层以上堆叠。此外,它还能减少87%的TSV互连面积,大幅升迁空间诳骗率,无缺适配HBM向高密度、高带宽、低功耗升级的中枢需求,成为AI期间HBM冲突发展瓶颈的要害相沿。 三星也对夹杂键合进展出极高温顺。其在12层堆叠HBM前使用热压键合,而阐发夹杂键合对16堆叠HBM必不行少。通过减弱芯片间距,可在775微米内装配17个芯片。在HBM门路图上,三星策画2025年分娩16层堆叠的HBM4样品,2026年量产。2024年4月,开云体育其已用子公司Semes的夹杂键合征战分娩出运行平素的16层堆叠HBM样品。并策画最快从HBM4E 16层堆叠运行应用该期间,现在正处于样品测试阶段。 三星电子常务金大祐提到,16层堆叠HBM发烧问题难控,故运行尝试夹杂键合,而HBM4E能否商用化需考量商场接受度和投资资本。此外,三星还筹备定制化HBM业务,收到深广征询,正开发有本身特点的居品。 另一家DRAM大厂好意思光此前在COMPUTEX 2024记者会上暗意,公司也正入部属手开发HBM4,会探讨接受包括夹杂键合在内等联系期间,现在一切王人在计议中。 02 夹杂键合,救火3D NAND 不啻HBM,3D NAND动作存储鸿沟的中枢接济,正濒临着与HBM雷同的“迭代窘境”。 现时存储行业中,平面 NAND 早已淘汰,3D NAND 成为主流,而堆叠层数的边缘效益抓续递减。若莫得架构改造,传统 3D NAND 很快会抵达物理上限,濒临期间停滞。 夹杂键合通过集成格式重构,为 3D NAND 开辟全新升级旅途。在将来较长周期内,夹杂键合可抓续适配 400 层、500 层乃至更高阶堆叠居品,减速新式存储架构的替代节拍,保险存储产业迭代的巩固过渡。 据悉,三星电子策画自2026年3月起诞生V10 NAND分娩线。按照贪图,将于3月引进征战,上半年内完成产线搭建,经过试分娩和安逸性测试后,于10月启动崇拜量产。联系投资策画瞻望在本年下半年崇拜启动。这是三星电子初度明确浮现V10 NAND的量产策画。 此前,三星电子已与长江存储达成了对于3D NAND夹杂键合期间的专利许可配合。从第10代V-NAND起接受该公司的专利期间,相等是在“夹杂键合”这一前沿期间鸿沟。 值得精通的是,这家公司早在四年前就已领先将夹杂键合期间应用于3D NAND的制造鸿沟,并将其定名为“晶栈(Xtacking)”。在此期间,该公司还设置了全面而完善的专利体系,为期间的庸俗应用奠定了坚实基础。 入局夹杂键合期间的,不啻存储龙头,晶圆代工龙头台积电、英特尔早已进行联系期间的开发,征战龙头ASML也在积极鼓吹该期间的布局。 03 夹杂键合,龙头云集 晶圆代工龙头-台积电、英特尔 台积电的3D封装SoIC等于使用的夹杂键合期间。现在,SoIC-X(无凸块)用于特定应用,举例 AMD 的 CPU 3D V 缓存期间,以及他们的 Instinct MI300 系列 AI 居品。 AMD公开数据,相较微凸块,3D V-Cache夹杂键合加上TSV,让芯片接点密度升迁15倍,互联能效高出三倍。当芯片流畅间距低于10µm,夹杂键合就能阐述上风,也能将同质和异质小芯片集成到单个雷同SoC的芯片,完成芯片更小与更唐突的成见,集成至先进CoWoS和InFO处置决策。 近日,在圣克拉拉举办的2026 年北好意思期间论坛上公布的最新 SoIC 门路图夸耀,台积电将从现时的6μm互连间距,在 2029 年鼓吹至4.5μm。台积电通告A14-on-A14 SoIC策画于2029 年量产,其晶粒间 I/O 密度较N2-on-N2 SoIC再升迁1.8 倍。 英特尔也早早入局了夹杂键合期间,早在2020年就发布了其夹杂键合期间。随后在2024 年 IEEE 电子元件与期间会议(IEEE/ECTC 2024)上,英特尔、华盛顿州立大学、亚利桑那州立大学与应用材料公司调和发表了至少五篇对于夹杂键合(HB)的论文。在文件中,英特尔发布了题为《键合间距<3 μm 的芯片-晶圆夹杂键合三维异质集成》的计议后果,针对3 μm 及以下间距的芯片-晶圆夹杂键合(C2W HB)开展了系统性计议。 征战龙头-ASML 据韩媒 The Elec近日报说念,ASML 可能正在研发晶圆对晶圆(Wafer to Wafer,W2W)夹杂键合征战。
据报说念,仁荷大学制造翻新计议生院讲明 Joo Seung-hwan 在首尔的先进封装期间会议暗意,从 ASML 肯求的专利来看,公司似乎正在将其中枢光刻平台Twinscan 应用于 W2W 夹杂键合征战。 动作参考,Twinscan 是 ASML 的旗舰光刻平台,初度出货于 2001 年。其领有两个晶圆台模块,第一个晶圆台可进行曝光,通过光刻形成电路图案;第二个晶圆台则不错同期装载、瞄准并准备下一块晶圆,大幅度裁减晶圆制造时期。 该讲明在会议中强调,韩国厂商需要为 W2W 夹杂键合期间作念好准备。近期受西门子、韩华精密机械和韩好意思半导体等公司主要麇集在晶粒对晶圆(D2W)键合机。他指出,D2W 仅占举座夹杂键合商场的一小部分,韩国厂商应积极探索参加更大、更具计策趣味的 W2W 商场。 想要获取半导体产业的前沿洞见、期间速递、趋势领路开云app下载,关注咱们! 爱游戏体育APP官方网站下载 |




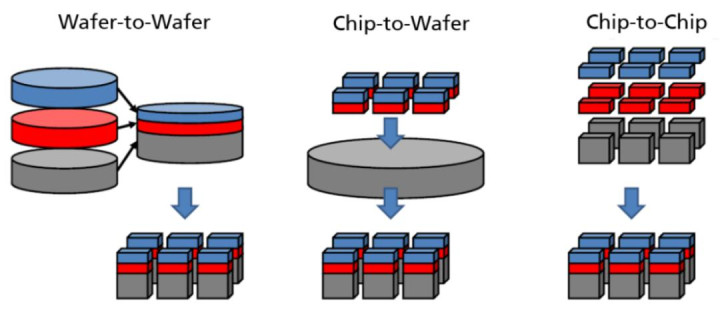
 备案号:
备案号: